博文
2020年第21期封面故事: 全芯片光源掩模优化技术新进展
|
计算光刻|全芯片光源掩模优化技术新进展
微信链接:
1、引言
光刻机是集成电路制造的核心装备,其作用是将承载集成电路版图信息的掩模图形以成像的方式转移至硅片面的光刻胶内,其技术水平决定了集成电路的集成度,关乎摩尔定律的生命力。
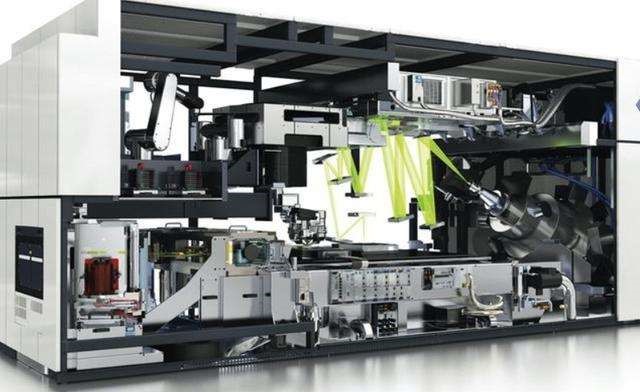
光刻机(图片来自网络)
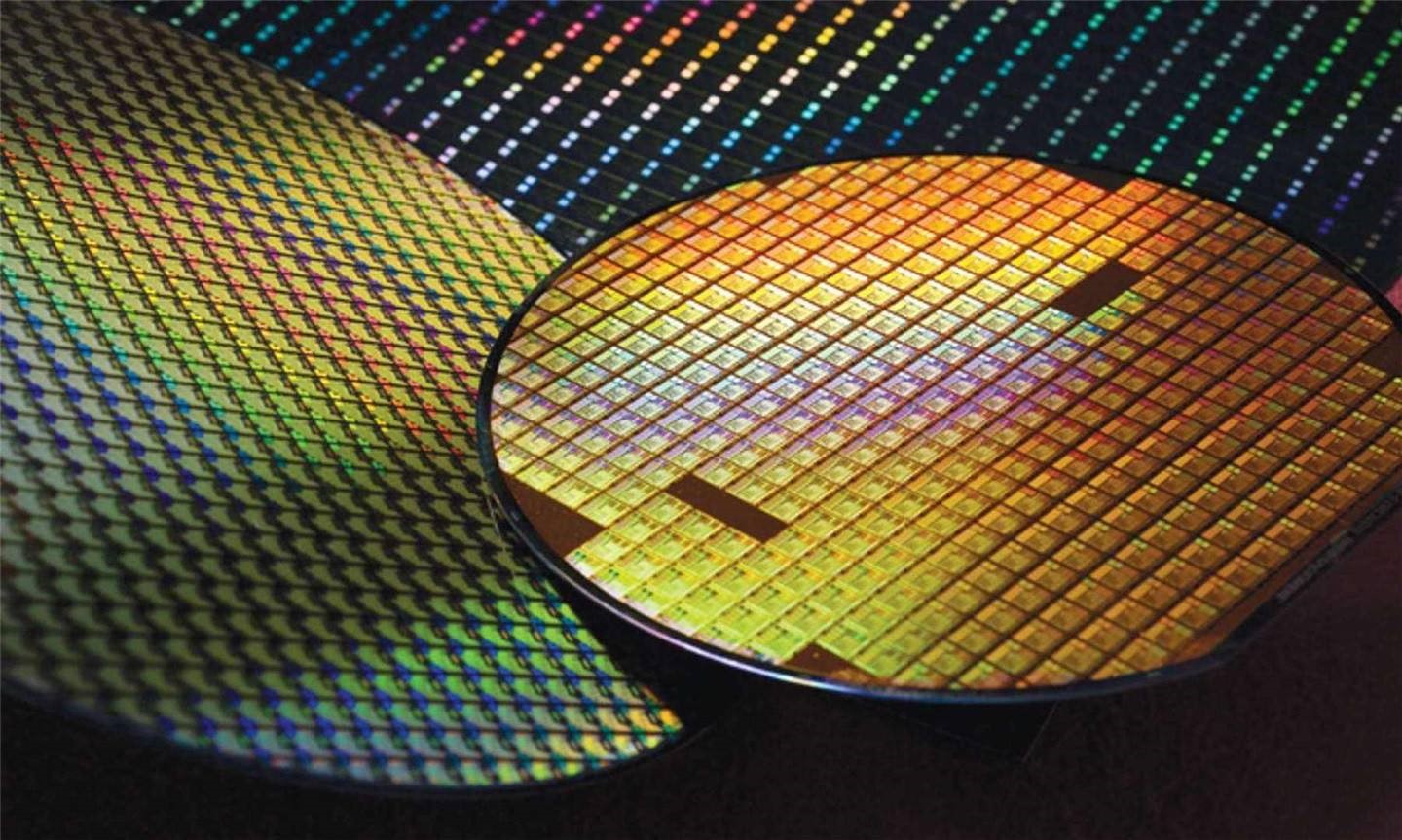
晶圆和芯片(图片来自网络)
为实现更高的光刻分辨率等性能指标,光刻机软硬件系统不断发展。照明系统由传统照明发展为自由照明。投影物镜由干式发展到浸液式,数值孔径不断增大、像差不断减小。掩模台、工件台、对准、调焦调平等系统不断发展。然而,光刻机系统的更新换代是阶段性的,一种新机型诞生后,其软硬件在较长的一段时间内基本保持不变。这种情况下如何提高光刻分辨率/增大工艺窗口成为推动芯片向更高集成度发展的关键。(王向朝、戴凤钊、李思坤、段立峰、施伟杰、唐锋,《集成电路与光刻机》,科学出版社,2020)
在光刻机软硬件不变的情况下,采用数学模型和软件算法对照明模式、掩模图形与工艺参数等进行优化,可有效提高光刻分辨率/增大工艺窗口,此类技术即计算光刻技术(Computational Lithography),被认为是二十一世纪推动集成电路芯片按照摩尔定律继续发展的新动力(Intel公司, “Computational Lithography: The New Enabler of Moore’s Law”, Proc. SPIE Advanced Lithography, 6827, 68271Q, 2007)。
光源掩模优化技术(Source and mask optimization, SMO)是实现28 nm及更小技术节点集成电路芯片制造的关键计算光刻技术之一。理想情况下SMO需要以代表全芯片掩模图形的图形集合(可含上千个图形)为输入优化照明模式,然后以全芯片掩模图形为输入进行掩模优化。全芯片掩模图形的数据量大,可达几百GB。直接以代表全芯片掩模图形的图形集合为输入进行SMO耗时过长,实际应用中不可接受。

芯片掩模图形(图片来自网络)
为提高SMO的优化速度,目前业界普遍的做法是:利用关键图形筛选技术从代表全芯片掩模图形的图形集合中筛选出少量具有代表性的关键图形。以关键图形代替图形集合进行优化,通过减少输入图形的数量,提高SMO的优化效率。为兼顾SMO的实施速度与效果,一方面要求关键图形筛选技术筛选出的关键图形尽量少,以提高SMO优化效率,另一方面要求筛选出的关键图形能够最大限度地代表所有图形的光刻成像特性,以保证SMO的实施效果。因此,关键图形筛选技术是决定SMO速度与效果的主要技术因素之一。
2、SMO关键图形筛选技术
中科院上海光机所王向朝研究员课题组提出了一种SMO关键图形筛选技术。该课题组以图形的主要频率表征图形特征,设计了相应的主要频率提取方法、覆盖规则、聚类方法以及关键图形筛选方法,实现了SMO关键图形的有效筛选。与中科院微电子所计算光刻研发中心韦亚一研究员课题组合作,采用荷兰ASML公司的TachyonTM商用计算光刻软件(国际上最先进的商用计算光刻软件之一)进行了仿真验证。该技术与商用计算光刻软件筛选出的关键图形数量相同,同时该技术获得的工艺窗口优于商用计算光刻软件中的同类技术。
参考国际上最大芯片代工厂之一GLOBALFOUNDRIES公司的测试图形集设计了图形集合。对该图形集合进行关键图形筛选,该技术和商用计算光刻软件分别筛选出相同数量的关键图形。采用TachyonTM软件分别对筛选出的关键图形进行SMO,得到的优化光源如图1所示。
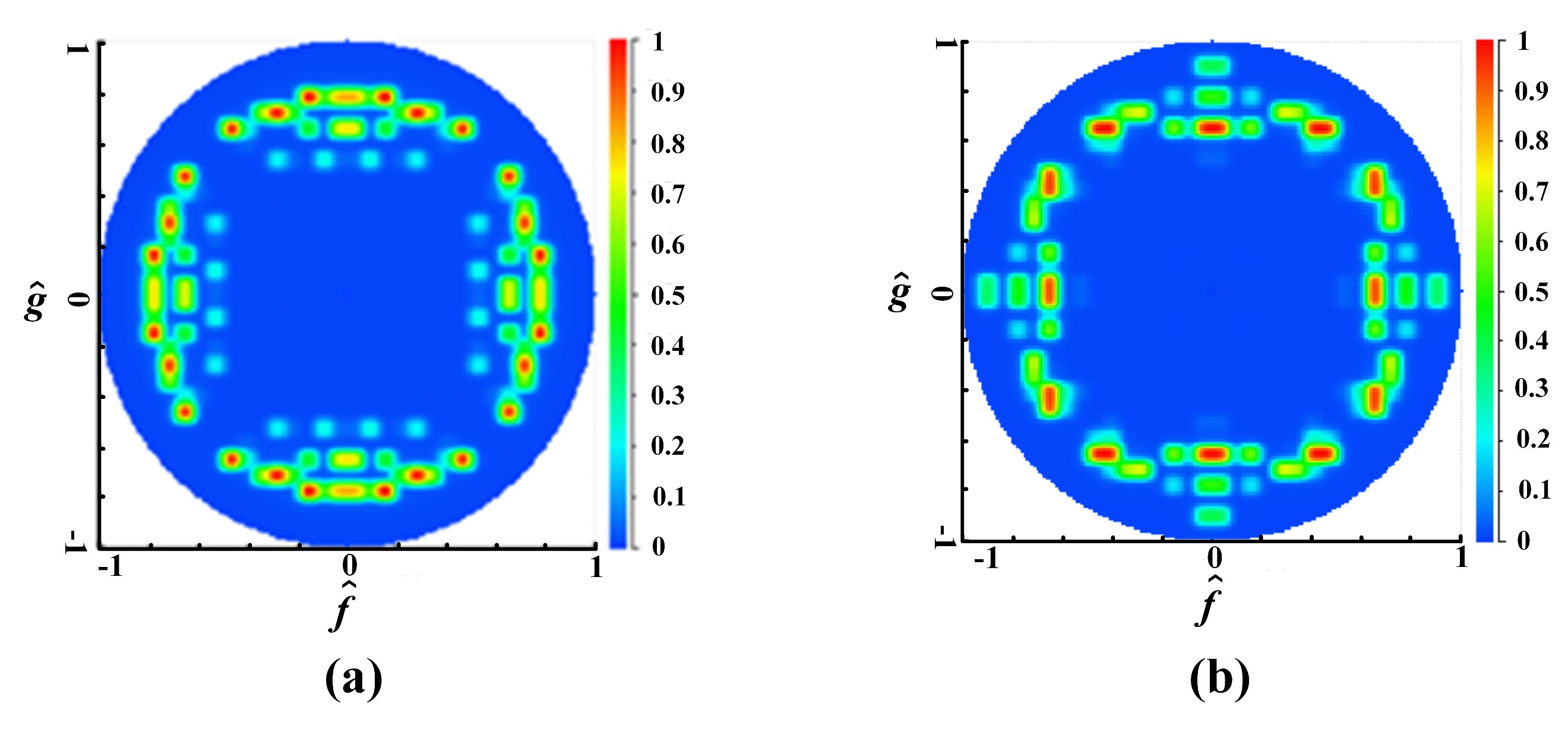
图1. SMO后的优化光源:(a)该技术;(b)商用计算光刻软件
利用优化光源分别对全部图形进行掩模优化。最终获得的工艺窗口如图2所示。图2(a)是两种技术获得的共同工艺窗口,其中的内接椭圆为2.5% 曝光宽容度(exposure latitude, EL)下的最大内接椭圆,图2(b)是两种技术的EL vs DOF(焦深)曲线。在不同EL下,该技术获得的工艺窗口均大于商用计算光刻软件的工艺窗口。如图2(b)所示,在5% EL情况下该技术可以获得工艺窗口,但商用计算光刻软件的筛选结果无法获得工艺窗口。在2.5% EL和10% 关键尺寸偏差条件下该技术获得的DOF为72.72nm,商用计算光刻软件获得的DOF为63.32nm,该技术获得的工艺窗口更大。
采用了自主开发的大尺度优化设计方法,基于严格的矢量角谱理论和时域有限差分法深入研究了多种典型制造误差对大尺度超振荡平面透镜聚焦性能的影响,将多种典型制造误差分为横向和纵向制造误差加以定量研究,如图2所示。
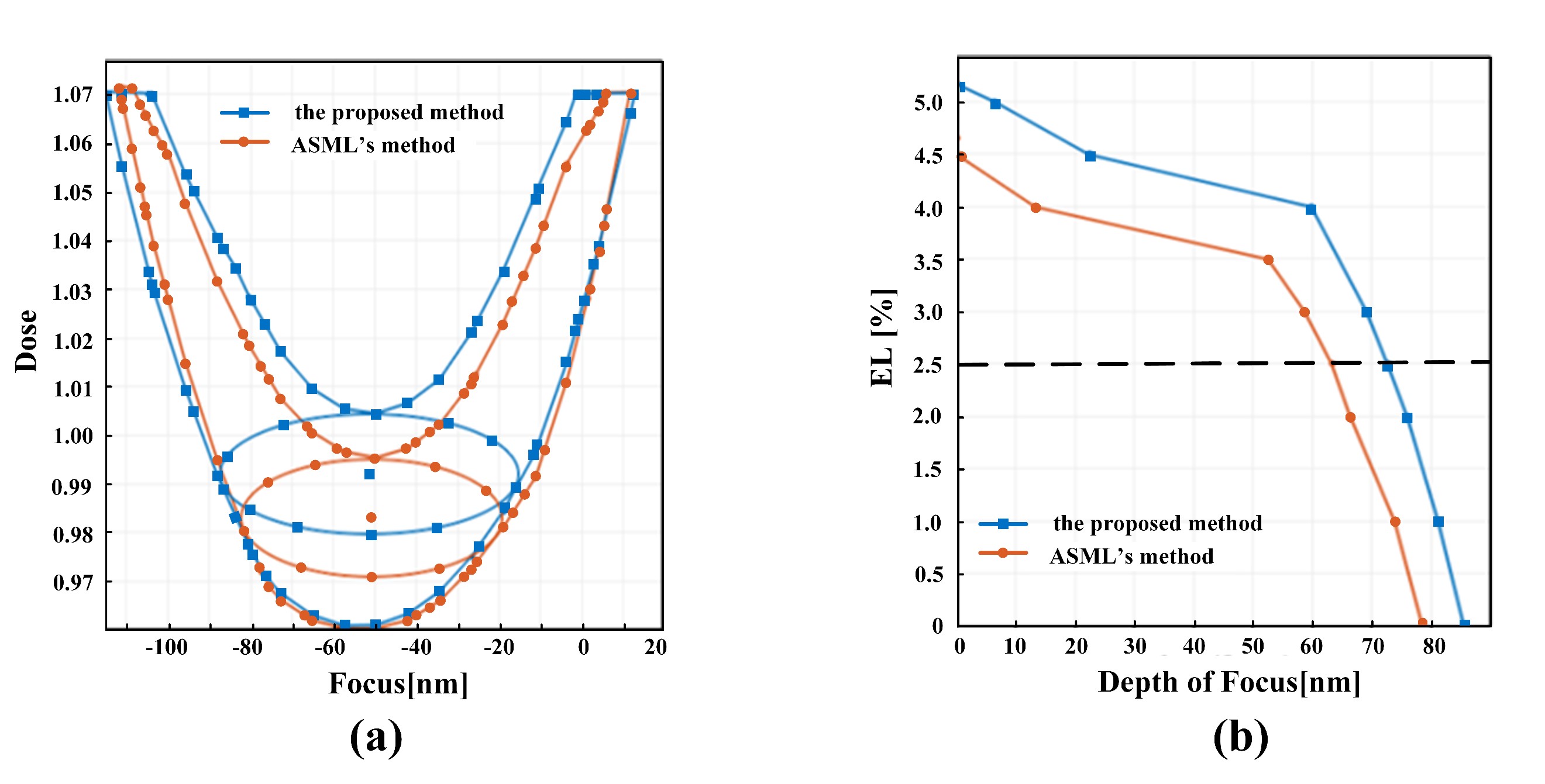
图2采用两种光源对所有图形进行掩模优化后获得的工艺窗口(a)共同工艺窗口;(b)EL vs. DOF曲线
商用计算光刻软件是该领域常用的研究与工程应用软件,其仿真结果符合真实工艺情况。目前商用计算光刻软件主要为欧美企业垄断,需要通过高额租赁费获取使用授权许可。本工作的合作双方利用ASML TachyonTM商用计算光刻软件进行的仿真结果表明该技术的性能优于商用计算光刻软件中的同类技术。
3、展望
该课题组后续将对覆盖规则、聚类方法以及关键图形筛选方法等关键子技术进行优化和改进,进一步提升该技术的性能。
每期封面:
https://m.sciencenet.cn/blog-3233766-1259578.html
上一篇:【《光学学报》创刊40周年庆】探索绝对重力仪,追求极致中国‘g’
下一篇:【《光学学报》创刊40周年庆】师法自然 | 飞秒激光精细雕琢超疏水表面




